Photonics Systems Group GmbH
【次世代PCB製造の課題を解決】
半導体・エレクトロニクス製造に関わる皆様、高密度実装が進む中での**PCB分割(デパネリング)**の課題を解決するソリューションをご紹介します。
私たちが代理店を務めるドイツのPhotonics Systems Groupは、世界トップ企業に採用される超高精度レーザーシステムを提供しています。
【PSGのレーザーデパネリングの優位性】
比類なき精度: 従来の工法では不可能だった複雑なデパネリングや、微細化・高密度化が極限まで進んだPCBの分割に最適。
歩留まり向上と高速化: デュアルレーザーシステムにより、処理速度が倍増し、生産性が向上。非接触加工のため、部品へのストレスやチッピング(欠け)を完全に排除します。
幅広い対応: デバイスICのフロントエンドからPCBパッケージング、太陽光発電まで、幅広いレーザー加工用途の専門製品ラインナップを提供。
この革新的な技術が、どのように貴社の製造コスト最適化と品質向上に貢献するか、ぜひ動画でご覧ください。
次世代レーザーデパネリング DP10XX
リジッド・フレックス両対応PCBA用 多用途レーザーデパネリングプラットフォーム
- 応力や切りくずの発生しないレーザー加工
- 炭化なしで高精度・高品質なカット
- 最大パネルサイズ 45.72cm × 45.72cm ※オプションで600mm x 300mmに変更可能
- 幅広いレーザー発振器オプション
- 第2加工ヘッド搭載
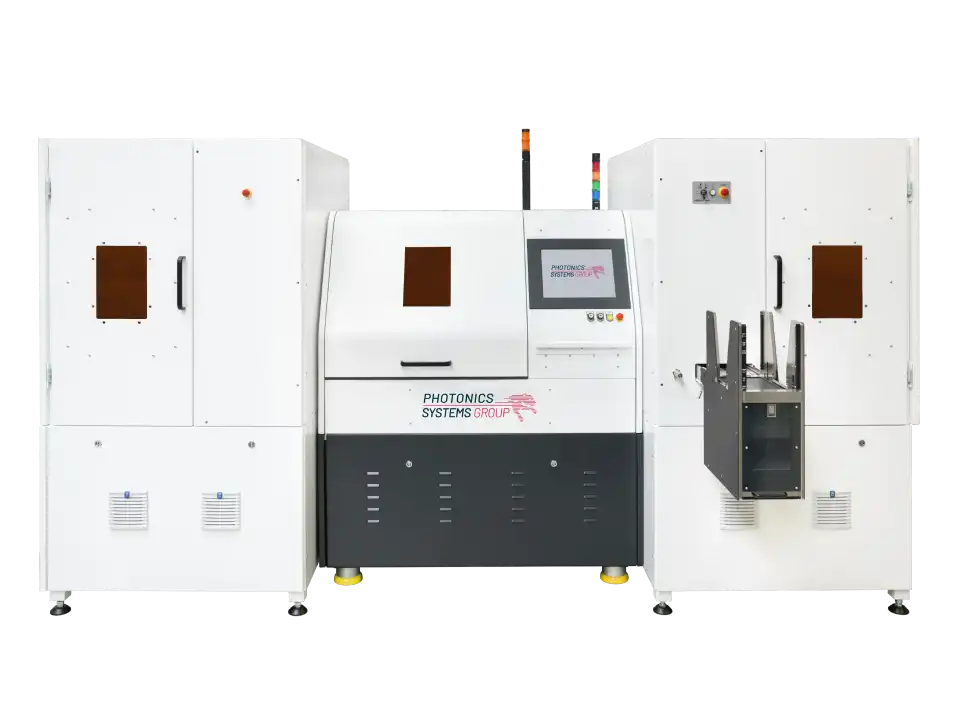
各種装置は「Ipros」に掲載中です。https://mono.ipros.com/company/detail/2117189/
次世代パッケージ基板用レーザードリリング装置|最小ビア径5μm
UHDI・パッケージ基板の微細穴あけに。SAP工法を支える超高精度レーザー
次世代の高速通信(5G/6G)や高性能計算(HPC)に不可欠なパッケージ基板 試作から量産まで対応する、Photonics Systems Group(PSG)製の高精度レーザードリリング装置です。
本装置はピコ秒レーザーを採用しており、従来のナノ秒レーザーやドリル加工では困難だったグラスエポキシ 微細加工において、熱影響(HAZ)を極限まで抑制。炭化やバリの発生を抑えることで、後工程のデスミア(Desmear)工程削減に大きく貢献し、歩留まり向上とコストダウンを同時に実現します。
特に、微細な配線形成が必要なSAP(Semi-Additive Process)やMSAP(Modified Semi-Additive Process)において、最小ビア径5μm〜という圧倒的な微細加工能力と、±5μmの高い位置精度が、貴社の次世代デバイス開発を強力にバックアップします。
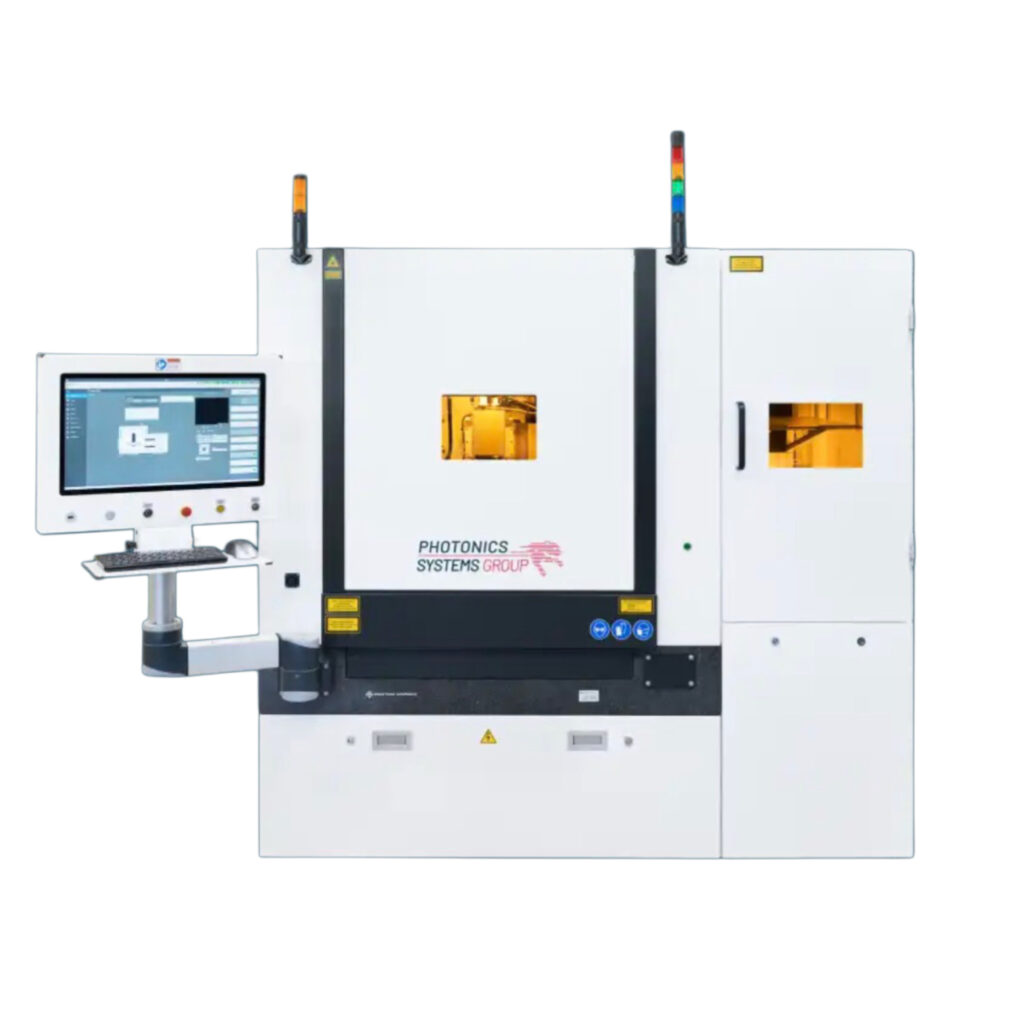
- ピコ秒UVレーザー使用(加工素材に合わせてUV/グリーンの選択が可能)
- フレキシブル基板、ABF、超高精細プリント基板(UHDI)およびICパッケージ基板の穴あけ・配線加工向けに特別に設計
- 超短パルスレーザー光源の幅広い選択肢
- 無限スキャン:ガルバノスキャナとステージ間の同期動作
- パネルサイズ:610 x 610 mm (24“x24“)
- ダブルレーザーヘッドで 2パネルに対応
- ビアサイズ >5 µm
- 精度 ±5 μm (4s)
- スピード >4000 holes/s (Ø20µm in ABF/BT)
- 素材:FR4, Polyimide, CCL, ABF, Coverlay, BT, RT, Rogers
各種装置は「Ipros」に掲載中です。https://mono.ipros.com/company/detail/2117189/
